| 知识小科普 | 您所在的位置:网站首页 › spice model › 知识小科普 |
知识小科普
|
摘 要:针对分立SiC MOSFET器件,本文进行了两种SPICE模型的对比研究,其中一种是制造商提供的模型,另外一种是我们新开发的模型。本文对两种SPICE模型的组成元件进行了详细的对比。最后通过对仿真开关波形与实测开关波形的对比来验证两种模型的准确性。 1. 引 言 SPICE模型作为实际应用中的一种标准模型在电路仿真中得到了广泛的应用。近年来,随着SiC MOSFET的快速商业化,SPICE模型开发成为一个活跃的研究领域[1][2]。 一些SiC MOSFET制造厂商已经可以提供SiC器件的SPICE模型,从而可以评估SiC器件在电力电子变换电路中的表现[3][4]。为了给电路设计者提供更精确和更实用的模型,SPICE模型一直在不断地发展。例如,Wolfspeed公司为其1200V分立SiC MOSFET开发了第3代SPICE模型,此模型可以更好地展现其输出特性和温度依赖性[5]。SPICE模型的准确性至关重要,这将是电路设计人员进一步研究的主题。 本文针对商用分立SiC MOSFET的两种SPICE模型做了对比。一种是广泛应用的制造商提供SPICE模型,这种模型在制造商的官网可以免费下载。另外一种是基于Simplorer模型新开发的SPICE模型。后一种模型可以成功描述SiC MOSFET寄生电容与极间电压的非线性关系。 两种模型的准确性通过仿真与实测的开关波形来验证,重点对比了dvDS/dt, diD/dt和高频下对散热器的漏电流。 2. 模型对比 本文以商用1200V、36A、标准TO-247封装的分立SiC MOSFET器件(C2M0080120D)作为DUT(DeviceUnder Test,待测器件)。 图1为一种SiC MOSFET器件SPICE模型的电路原理图,包含三个电极(栅极、漏极和源极)、一个SiC MOSFET内核(用以描述其输出特性)、寄生电容(CDG、CDS、CGS)、内部栅极电阻RGint、寄生杂散电感(LG、LS、LD)。 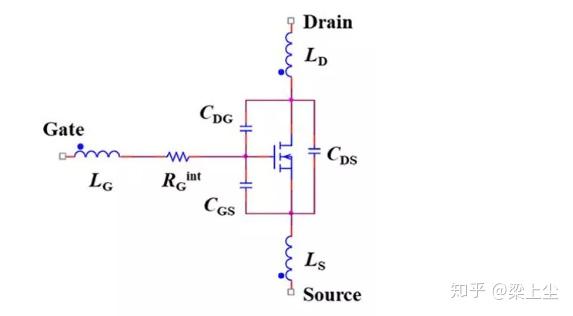 图1:一种SPICE模型的电路原理图 表Ⅰ为SPICE模型的组成元件对比。 为了实现精确的SPICE模型,内部栅极电阻是不可或缺的,尽管其相对于外部栅极电阻阻值较小,但是内部栅极电阻上面的压降补偿能够使栅源极电压更加精确,进而影响SiC MOSFET的输出特性。 制造商的SPICE模型设定内部栅极电阻为4.6Ω,这是一个典型值并被标注在规格书中。而新的模型基于LCR测量法设定为3.6Ω。这些内部栅极电阻的阻值在SPICE库文件(.lib)里面是需要被定义的。 无论对分立器件还是模块,封装的杂散电感取值一直是器件建模的争议点。 制造商的SPICE模型中,栅极杂散电感为15nH,漏极杂散电感为6nH,源极杂散电感为9nH,但是这些杂散电感感值的取值方法并未透漏。 新SPICE模型设置漏极电感为2.5nH,源极电感为4.5nH,并且设置他们之间的耦合系数k为0.46。这些参数是通过文献[7]所述的实验方法获得的。新SPICE模型的杂散电感比制造商的SPICE模型的一半还小,并且是通过实验数据得到的。这些杂散电感的感值在SPICE库文件(.lib)里面也是需要被定义的。 表Ⅰ:两种SPICE模型的详细对比 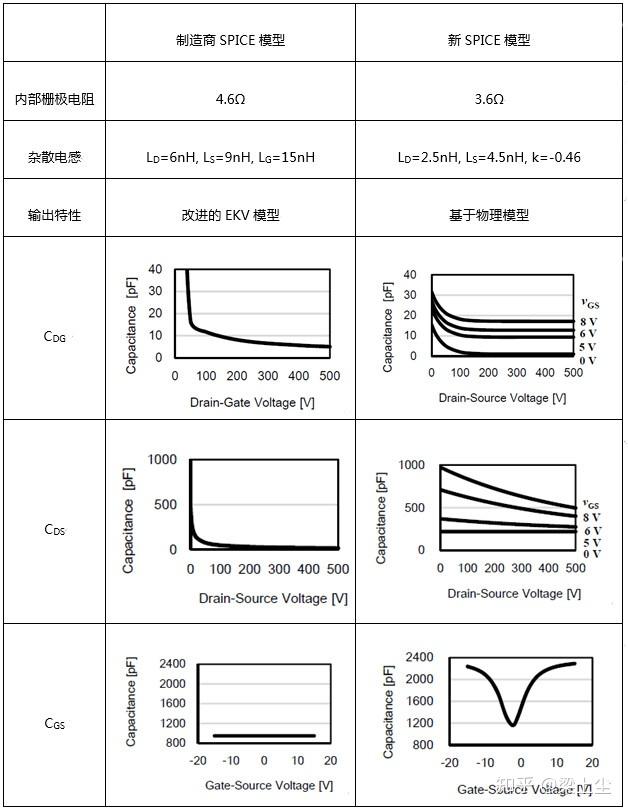 输出特性是MOSFET内核模型的基本特性。 制造商的模型采用改进的EKV模型,此模型的公式如附录1所示。新模型在线性区采用物理模型,对饱和区采用行为近似。输出特性模型采用了电压控制电流源。 众所周知,寄生电容是决定器件开关特性的最重要元件。 如表Ⅰ所示,制造商的模型中,CDG是非线性的,且仅与VDG电压相关,采用具有双曲转移函数的电压控制电流源(转移电导G)来近似模拟CDG随VDG电压升高而逐渐下降的特性。 CDS与VDS电压相关。采用体二极管子电路模型的结电容来表示CDS。另外,体二极管还有一个与diD/dVDS成比例的扩散电容。对于CGS,设定为恒定值950pF。 然而,新SPICE模型,CDG与VGS、VDS电压相关,CDS也与VGS、VDS电压相关。VGS依赖性表示MOSFET处于通态状态时的电容值。利用电压控制电流源对VDS的指数近似和对VGS的双曲近似来表示CDG。同样,利用电压控制电流源对VDS和VGS的sigmoid函数近似来表示CDS。对于CGS,新模型采用依赖于VGS的模型。从表Ⅰ可以看出,与制造商模型相比,新模型的寄生电容模型较为复杂。 3. 开关波形对比 通过带电感负载的双脉冲开关试验来验证以上模型。如图2所示的开关测试试验装置,包含下桥臂SiC MOSFET(待测器件),作为续流二极管用的上桥臂SiC MOSFET,与之串联的直流支撑电容,与上桥臂SiC MOSFET并联的空心电感,以及商用化的栅极驱动电路(GDU40-2)。  图2:带电感负载的双脉冲开关试验装置 图3为两种模型在漏极电流为20A时VDS、iD和高频漏电流的瞬态仿真波形与实测结果对比。从图中可以看出,新模型的仿真波形与实测波形吻合较好,而制造商模型的仿真波结果比实测结果具有更快的响应速度。这种改进主要归功于非线性电容模型在新SPICE模型中的成功应用。 表Ⅱ总结了dvDS /dt、diD/dt在开通和关断米勒平台时的两种模型对比。  高频漏电流的对比直接反映了两种模型的dvDS /dt。 图3:漏极电流为20A时的仿真与实测开关波形对比 表Ⅱ:dvDS/dt和diD/dt对比  4. 结 论 本文对分立SiCMOSFET器件的两种SPICE模型做了对比研究。结果显示,新模型相对于制造商模型在开关波形、dvDS /dt、diD/dt和对散热器高频漏电流方面的精确度有显著的提高。新模型的优异性能表明最新SPICE建模技术还有很大发展空间。 5. 附录Ⅰ 制造商模型中的改进EKV公式如式(1)所示:  上式中,KS为亚阈斜率,Φt为热电压,λ为沟道长度调制系数。同时,式(1)采用对数公式来分别表示两个电压控制电流源。 6. 参考文献 [1] C.He, J. Victory, M. B. Yazdi, K. Lee, M. Domeij, F. Allerstam and T. Neyer,"A physically based scalable SPICE model for silicon carbide power MOSFETs,"IEEE Applied Power Electronics. Conference and Exposition, pp. 2678-2684, 2017. [2] F.Hsu, C. T. Yen, C. C. Hung, C. Y. Lee, L. S. Lee, K. T. Chu and Y. F. Li,"High accuracy large-signal SPICE model for silicon carbideMOSFET,"IEEE 30th International Symposium on Power Semiconductor Devicesand ICs, pp. 403-406, 2018H. [3] A.Stefanskyi, ?. Starzak and A. Napieralski, "Review of commercial SiCMOSFET models: Topologiesand equations," 24th International Conference Mixed Design of IntegratedCircuits and Systems, pp. 484-487, 2017. [4] A.Stefanskyi, ?. Starzak and A. Napieralski, "Review of commercial SiCMOSFET models: Validity and accuracy," 24th International. ConferenceMixed Design of Integrated Circuits and Systems, pp. 488-493, 2017. [5] T. S. Ong, “High PowerSwitching Device, SiC MOSFET LTspice Model,” Industry Session: Modeling & Simulation,IEEE Applied Power Electronics Conference and Exposition, 2018. [6] Y.Mukunoki, Y. Nakamura, T. Horiguchi, S.Kinouchi, Y. Nakayama, T. Terashima, M. Kuzumotoand H. Akagi, "Characterization and Modeling of a 1.2-kV 30-ASilicon-Carbide MOSFET," in IEEE Transactions on Electron Devices, vol.63, no. 11, pp. 4339-4345, Nov. 2016. [7] Y.Mukunoki, Y. Nakamura, K. Konno, T. Horiguchi, Y. Nakayama, A. Nishizawa, M. Kuzumotoand H. Akagi, "Modeling of a Silicon-Carbide MOSFET With Focus on InternalStray Capacitances and Inductances, and Its Verification," in IEEETransactions on Industry Applications, vol. 54, no. 3, pp. 2588-2597, May-June,2018. [8] H.Sakairi, T. Yanagi, H. Otake, N. Kuroda and H. Tanigawa, "MeasurementMethodology for Accurate Modeling of SiC MOSFET Switching Behavior Over WideVoltage and Current Ranges," in IEEE Transactions on Power Electronics,vol. 33, no. 9, pp. 7314-7325, Sept. 2018. [9]Silicon Carbide Power MOSFET, C2M0080120D Cree Datasheet, 2013. [10]K. Hasegawa, K. Wada and I. Omura, "Mutual inductance measurement forpower device package using time domain reflectometry," IEEE EnergyConversion Congress and Exposition, pp. 1-6, 2016. [11]Y. Mukunoki, K. Konno, T. Matsuo, T. Horiguchi, A. Nishizawa, M. Kuzumoto, M.Hagiwara and H. Akagi, "An Improved Compact Model for a Silicon-CarbideMOSFET and Its Application to Accurate Circuit Simulation," in IEEETransactions on Power Electronics, vol. 33, no. 11, pp. 9834-9842, Nov. 2018. [12]B. N. Pushpakaran, S. B. Bayne, G. Wang and J. Mookken, "Fast and accurateelectro-thermal behavioral model of a commercial SiC 1200V, 80mΩ powerMOSFET," IEEE Pulsed Power Conference, pp. 1-5. 2015.来源:三菱电机半导体 泰科天润官网:碳化硅,半导体,功率器件,电动车,光伏,电力电子 - 泰科天润半导体科技(北京)有限公司 微信公众号:globalpowertech |
【本文地址】